Decrease in Deposition Rate and Improvement of Step Coverage by CF4 Addition to Plasma-Enhanced Chemical Vapor Deposition of Silicon Oxide Films
Jpn. J. Appl. Phys. Vol. 39(2000) pp.330-336
< Last Update : Nov. 9 2008 >
この論文の著者の中には,東京大学の霜垣先生(外部サイト:霜垣先生の研究室)や小宮山先生(外部サイト:Wiki)の名前が含まれています.化学工学の分野では著名なお二人ですので,ご存知の方も多いと思います.霜垣先生には,Anelva に在職中,Cu CVD プロセスのシミュレーションに関して色々とご指導頂きました.
さて,取り上げられているプロセスは,低誘電率の層間絶縁膜に関するもので,プロセスガスとして SiH4/N20/Ar 及び SiH4/N2O/CF4 を用いて比較しています.実験結果から分かっている事として,CF4 を添加すると成膜速度は減少する一方で,ステップカバレッジは向上する,といったことが始めに述べられています.論文の主眼は,その原因を数値解析の立場から説明することにあります.ただし,ここで言う数値解析は,装置全体を2次元・3次元モデルで計算する代わりに,零次元と呼べるモデルで検討した例になります.成膜速度分布を詳細に議論したものとは違いますが,空間を離散化して気相と表面に区別して考えれば一般の CFD の計算になりますから,考え方としては非常に参考になると思われます.STR( Semiconductor Technology Research, Inc. )が開発している CVDSim の反応モデルも,基本的には同様の考え方から成り立っています.
プラズマ生成(平行平板)のパラメータは,周波数:13.56MHz,投入電力:30W,基板温度:300℃,圧力:1Torr にそれぞれ固定されています.変更するプロセス条件は,Ar の代わりに CF4 を考慮する点と,総流量の2つです.ガスの流量比は固定( SiH4/N2O/Ar(CF4) = 1:10:50)されています.流量を増やすと成膜速度は少しずつ飽和する傾向を示しつつも上昇します.Ar を CF4 に置換すると,実験結果の成膜速度はやや減少します.
Pe数(輸送と拡散の比を表す無次元数)を評価し,その値が小さいことから,拡散が支配的なプロセス条件になっていることが分かります( Pe数の見積りについては,混合気体の特性と無次元数の見積もり でも取り上げています).1Torr というやや低い圧力ということもあり,見積もられた境界層の厚みは平行平板の間隔より大きいことから,境界層の厚みを平行平板の間隔に等しい,と仮定して議論を進めています.また,トレンチに成膜するプロファイルを比較・検討するために,test structure を用意し,そこに成膜するプロファイルを確認・比較することで,ステップカバレッジの議論をしています.断面写真から,CF4 を添加(Arを置換)した場合に,ステップカバレッジが向上していることを示しています.
成膜レートを表現する反応モデルの構築については,最初に簡易なモデルから出発し,徐々に practical なモデルへと修正・改良されます.詳しくは,実際の論文を参照して頂きたいのですが,実験結果を説明する為に,次の3つのモデルを提案・議論しています.
1.One film-forming species model
2.Two film-foriming species model
3.Modified Two-forming species model
まず,最初の簡易なモデルを図で示したものが,以下になります.
Fig. 1 One film-forming species model
F は流量,C 及び C0 は,ガスの濃度を意味します.Precursor が成膜種と考え,表面反応に関する速度定数を k,成膜する面積を S とします.反応速度定数 k は,k = vη/4 と定義されます.v は,ガスの熱運動速度,ηは,付着確率です.ちなみに,4で割っている理由は,両辺に n(ガスの密度)を掛けてみるとすぐに理解できます.ガスが壁に向う flux は,nv / 4 ですので,η = 1.0 の場合,flux そのものに一致します( flux の見積りについても,混合気体の特性と無次元数の見積もり の中で取り上げています).
供給量と生成量,消費量のバランス(質量保存)を考えると,以下の式が成り立ちます.
上式を変形して次式を得ます.
この式を利用して,成膜速度 DR は,以下のような式で表現することが出来ます.
M は Precursor の分子量,ρは,膜の密度を意味します.C0,S,M,及びρの値は,論文の中に具体的な数値が見つからなかった為,当たらずとも遠からずと思われる値を入れて計算してみたところ,定性的に同様の結果を得ることができました.なお,k の値は,論文で示されている値をそのまま利用しています(以下のグラフ作成には,Excel を用いました).
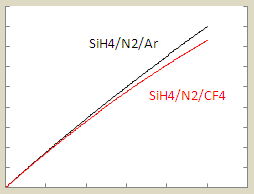
Fig. 2 総流量(横軸)に対する成膜速度(縦軸)
CF4に置換したモデルでは,若干ですが,成膜速度が下がることを確認できます.プロセス条件とステップカバレッジの傾向を説明するには,このモデルでは単純過ぎることが議論された後,成膜に寄与するガス種が2つ考えられるモデルを検討しています.そのモデルを図でモデル化したものが,以下になります.
Fig. 3 Two film-forming species model
気相中の反応で,Precursor が Intermediate へと変わり,その両方が成膜に寄与する,というモデルになります.k1 及び k2 は,path 1 及び path 2 の表面反応に対する速度定数,kg は気相の反応に対する速度定数,V は装置内の体積をそれぞれ意味します.この時の成膜速度分布 DR は,先のモデルと同様の考え方を利用し,以下のような式で表現することが出来ます.

k1,k2,kg は,それぞれ論文に示されている値(1.1[m/s],0.01[m/s],及び 45[m/s]) を用い,論文中に見つからない V の値については,S の値から矛盾しないと思われる範囲で仮定し,計算してみた結果が以下になります(論文の結果と同様の傾向が得られています).
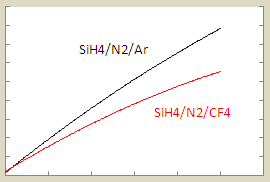
Fig. 4 総流量(横軸)に対する成膜速度(縦軸)
論文では,実験結果と定量的にも良い一致を示すことが説明されています.
更に議論を進め,Precursor が実際にはプラズマ中で生成されることを考慮・修正したモデルについても述べられています.そのモデルを図で説明したものが,以下になります.
Fig. 5 Modified two film-forming species model
Precursor は,SiH4 と電子の衝突から生成される,と考えたモデルで,より現実的なモデルとなっています.Precursor 及び Intermediate は,論文中には具体的に述べられていませんが,SiH3 や SiH2 等が考えられます.このモデルを用いて成膜速度を式で表したものが以下になります.

気相中の反応速度定数 k1,及び k2 は,論文中の値を用い,計算してみた結果が以下になります.
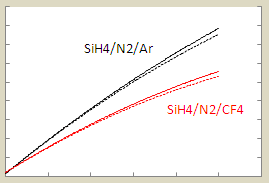
Fig. 6 総流量(横軸)に対する成膜速度(縦軸)
実線は,Fig. 4 の結果と大差ありませんでしたが,点線は,kg1(電子衝突による反応速度定数)をオーダーで下げてみた結果の一例です.論文の中でも述べられていますが,CF4 は成膜面を覆う反応阻害物として考えられ,成膜種の実効的な付着確率を下げ,その結果として成膜速度が下がっていることが理解できます(反応阻害物の役割については,以前,私自身が Al エッチングの圧力依存性を説明する際にも検討したことがあります.興味のある方は,[15],[16],[17],及び,[18] をご覧下さい).また,付着確率を下げることは,よりコンフォーマルな成膜を意味し,ステップカバレッジを向上されることも同時に理解できます.
このようなモデル化と定式化は,成膜速度が定性的にどう変化し,その key となる反応速度が何処にあるのかも示唆してくれます.CFD-ACE+ の Add on module を作成していた STR のモデルは,やや複雑なものもありますが,本論文で取り上げられている One film-forming species model や,プラズマを考慮しない Two film-foriming species model が基本になっています.また,論文では議論されていませんが,今回のモデル化を通して原料の利用効率といった点についても,詳細なシミュレーションをすることなく,見通しをつけることも可能です.
化合物半導体の CVD のプロセスは,圧力が大気圧か大気圧に近い条件下で成膜する場合も多く,境界層の厚みを考慮したり,気相中で微粒子(クラスター)の発生が生じる影響をモデルに加味し,修正する必要も出てきます.しかし,装置全体のモデルを CFD ソフトウェアを用いて数多く計算するだけでなく,今回のようなモデル化を利用して現象を理解することで,装置パラメータの何がどう影響するかを考えるヒントになり,そこから次のアイディアが出てくる可能性も高くなると思います.
back to home > learn_from_others
© 2008 ATHENASYS Co., Ltd. All Rights Reserved.
