( Transient simulation for alternative gas flow in CVD Reactor )
ALD(Atomic Layer Deposition)に代表される CVDプロセスでは,導入ガスを周期的に切り替えます.この時,ガスの流れや内部の分圧はどのようになっているのでしょうか.また,ガス温度はどう変化するでしょうか.
以下では,単純な2種類のガスを周期的に切り替えて導入した際に,装置内部のガスの流れ,分圧,温度分布がどのように変化するかについて検討した例をご紹介します.
☆
CVD装置は,シャワーヘッドを一段有する単純なモデルを想定しました.シャワーヘッドは,多孔質( porous media )でモデル化し,計算は二次元軸対称モデルを利用しました.
非定常計算を行うにあたり,仮定したプロセスは,以下のような Ar・O2 導入,及び排気を組み合わせたものです.
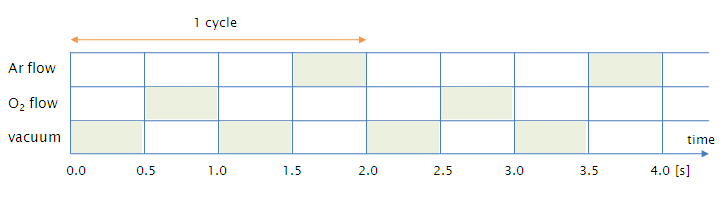
Fig. 1 非定常計算のプロセス
始めに Ar が導入されている定常状態を考え,排気 → O2導入 → 排気 → Ar導入というプロセスを,各0.5秒間ずつ,2サイクル計算します.
計算モデルの概略と Ar の定常状態(本モデルの初期条件)の結果を以下に示します.
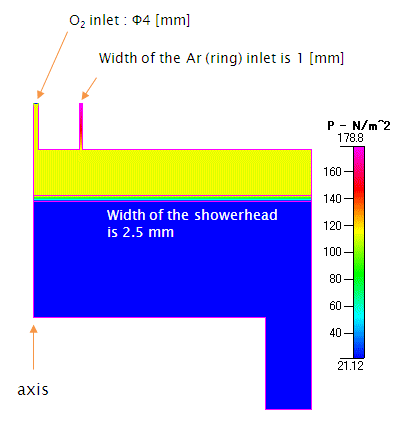
Fig. 2 計算モデル( Ar のみ流した定常状態の結果 )
O2 は,シャワーヘッドより上流側の中央より,Ar は O2 inlet の周辺(リング上の溝)から流入する仮定しました.各流量は,Ar/O2 = 1e-6/3e-7 [kg/s/rad] としています.
温度については,CVD装置の壁を 300K,サセプター表面を 700K と仮定しました.
本計算では,outlet 境界を設ける代わりに,ポンプを想定した多孔質の領域を設け,ガスを物理吸着させることで排気するモデルを取り入れています.従って,計算中の圧力の最低値は常に変化します.実際の装置でも,圧力は広い範囲で常に変動していることが考えられますが,排気をどうモデル化するかは,排気速度を直接与えることが難しい一般の CFD ソフトウェアで取り扱う際の課題の一つと考えられます.
計算を行うにあたり,以下の3点において圧力と Ar 及び O の質量分率( mass fraction )をモニターしました(Fig. 3 では,中心軸をX軸にとっているため,Fig. 2 の図とは90度回転して図示しています).
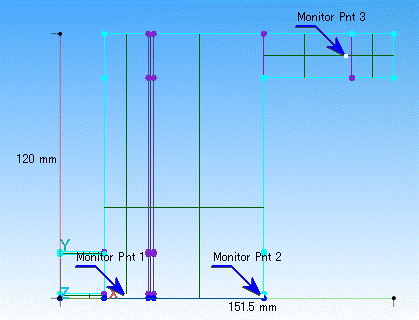
Fig. 3 圧力と Ar・O2 の mass fraction をモニターする箇所
Point-1(p1)はシャワーヘッドの上流,Point-2(p2)はサセプターの中央近傍,Point-3(p3)は排気口に近い場所を選んでいます.
☆
以下に,p1 及び p2 の圧力の変化を示します.なお,p2 と p3 では,大きな差異が見られなかったため,以下では p3 の結果は省略します.

Fig. 4 p1 及び p2 における圧力変化
サセプター近傍の圧力と比較すると,シャワーヘッドの上流側では,圧力が高いだけでなく,その変動も大きくなります.今回のプロセス条件では,排気する時間を 0.5s 設けていますが,シャワーヘッドの上流側では圧力が十分下がらず,ガスが抜け切っていないことを示しています.
次に,Ar・O2 の mass fraction の変化を示します
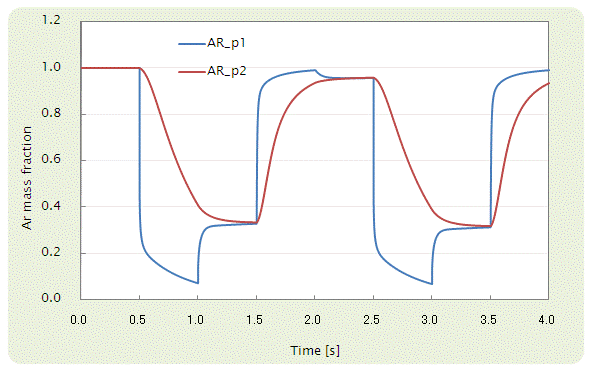
Fig. 5 p1 及び p2 における Ar の mass fraction の変化
O2 の mass fraction は,1 - ( Ar の mass fraction )となるので,Fig. 5 を逆さにした変化となります.
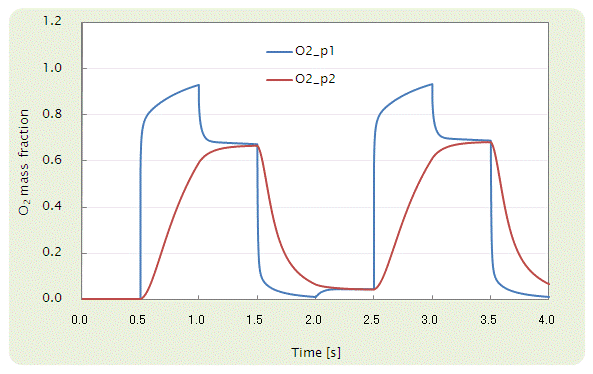
Fig. 6 p1 及び p2 における O2 の mass fraction の変化
シャワーヘッドの上流側では,排気 → Ar 導入することで,ガスの大半が Ar に切り替わりますが,流量の少ないO2 の場合,Ar ほどは切り替わらないことが分かります.また,サセプター近傍では,シャワーヘッド上流側に残った Ar が排気されるのにより長い時間を要することも影響し,常に Ar が相当量混合した状態になっています.シャワーヘッドを利用しない装置の場合でも,定性的には,これと同様の状況になっていると考えられます.
一般に,ガスを切り替えるプロセスでは,Key となるガスの分圧の変化に着目しますが,今回計算した結果から,気相中のガスの温度もかなり変化することが分かりました.以下に,圧力や温度の計算結果をアニメーションで示します.
☆

Fig. 7 圧力分布の変動( max/min を固定 )
左のグラフは,O2 と Ar の inlet の中間付近の断面において,横軸にサセプターからの距離をとってプロットしたものです.サセプターからシャワーヘッドまでの距離は 50mm,シャワーヘッドの厚みは 2.5mm,シャワーヘッドの上面からチャンバーの天井までは 20mm となっています.
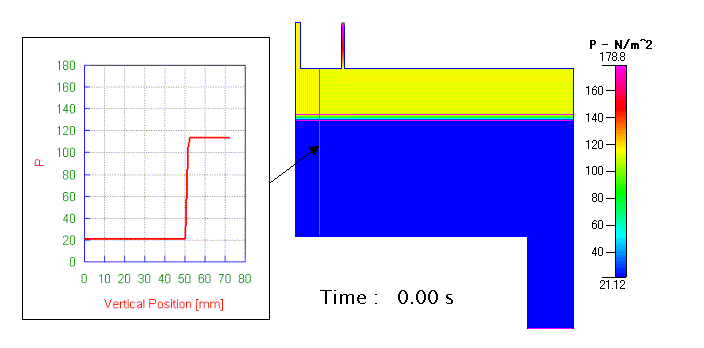
Fig. 8 圧力分布の変動( コンターの max/min は dynamic に変動 )
圧力のコンターは,各時刻毎に,計算領域内の最大値・最小値に合わせて変動します(ポンプを想定した多孔質の領域は,Fig.3 でのみ表示していますが,その他の図では省略しています).
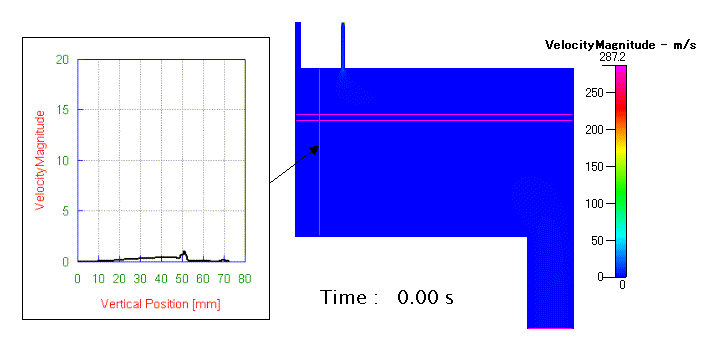
Fig. 9 流速分布の変動( max/min を固定 )
流速が大きくなるのは,チャンバー内に導入される領域に限られています.以下に,最大値を 10m/s に固定した速度分布を示します.
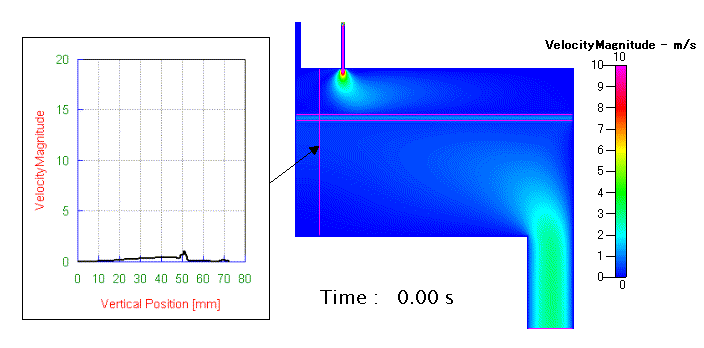
Fig. 10 流速分布の変動( コンターの最大値を 10m/s に固定 )
サセプターの脇では,常に,ガスがポンプ(を想定した領域)に向う流れが形成されており,定性的には妥当と考えられます.ただし,実際の圧力変動と一致するようなモデルにするには,実測との比較・検討が必要となります.

Fig. 11 Ar 分圧分布の変動
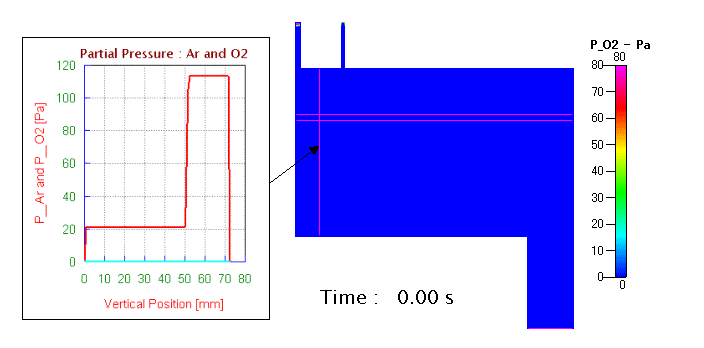
Fig. 12 O2 分圧分布の変動
シャワーヘッドを利用した装置では,短時間にガスを切り替えることは難しいことが,これらの結果からも予想できます.

Fig. 13 温度分布の変動
ガスの切り替えを行う際,排気する時間を設けていますが,その間はサセプター周辺の圧力が下がります.本計算では,slip wall と呼ぶオプションを利用し,壁でのスリップを考慮しています.低圧力で壁でのスリップが生じると,高温の壁に隣接するガス温度は,壁の温度と同じにはなりません.
排気されている間は,断熱膨張の効果でガス温度が下がることが考えられます.本計算例では,サセプター近傍のガス温度が50℃程度下がる結果となりました.基板が浮いた状態になっている場合,熱容量の小さい基板の表面温度は,若干下がる可能性が考えられます.
☆ 本計算では,auto time step と呼ぶオプションを利用していますが,time step の最小値をある程度大きくとっています.CFL条件を満たすように最小値を十分小さくすると,プロセスを切り替えた直後の圧力・速度分布が暴れる結果となり,現実的な解を得ることは難しいようです.切り替えた瞬間の状態をきちんと解析するには,超音速に対応可能な CFD-Fastran や粒子コードが必要かもしれません.
☆
back to home > products > CFD-ACE+
© 2008- ATHENASYS Co., Ltd. All Rights Reserved.
