1.4 実験や計算のプロセス条件
< Last Update : Dec. 30 2008 >
量産機で実際に使用するプロセス条件は,基板面内の不均一性を極力抑えた条件になっています.その為,基板の中央から端部に至る成膜レートの分布,及び,基板面上の周方向における成膜レートの分布は,比較的均一となっています.実際には,若干の分布を持っていますが,このように最適化された条件からは,反応のメカニズムを探ることは一般に困難です.
反応のメカニズムを探る場合は,最適化された条件ではなく,むしろ,面内に特徴的な分布が見られるプロセス条件を含める必要があります.勿論,量産機で使用する条件を含むことも重要ではありますが,温度や圧力,流量,可能であれば,装置内の特徴的な寸法を変更し,その影響を調べることが必要となってきます.
☆
複数のプロセス条件を振って,成膜速度や膜質がどのように変化するかを調べるには,大きく分けて,2つの段階があると思います.一つは,反応メカニズムが不明で,どのような反応モデルを構築すべきかを調べたり検討する段階,もう一つは,シミュレーションを実行するのに必要な条件はある程度揃っているが,より効率的にデータを収集する段階です.
後の方は,実際にはシミュレーションを行わず,実験結果だけからプロセスマージンを調べたりするケースも考えられます.装置の構造自体を大きく変えることなく,変更可能な条件を振って,その中から最適な条件を探す,という目的では,実験計画法を利用するのが恐らく最も効率的と思われます.その方法については,後に2.1で簡単にご紹介したいと思いますが,正しく実験計画法を利用すれば,一般的な多項式近似では得ることが難しいような狭いプロセスマージンを見つけることも可能です.例えば,
f(X,Y,Z)=C0 + C1*X + C2*Y + C3*Z * C4*X*Y + C5*Y*Z + C6*Z*X + C7*X^2 + C8*Y^2 + C9*Z^2
のような近似式で,あるデータをフィッティングする,という方法は多くの方が試す方法だと思います.最小二乗法等により,C0 〜 C9 までの各係数を求めることは可能です.しかし,この方法の大きな問題点は,少なくとも二つ上げられます.一つは,全ての項を残した関数が最適である理由も保障もないこと.もう一つは,他の最適な関数,例えば,指数・対数といった関数を考慮した方が現実的な場合,二次でフィッティングしても実用的な関数が得られないことです.
過去の経験では,上記のような単純なフィッティングでは,実際のプロセスの応答をうまく表現できることはほとんどなく,実験計画法をきちんと処理できるソフトウェアを用いるなどして正しく解析することが必要です.実験計画法を応用した例としては,実際の量産機に適応した例(文献[12]にあるスパッタリング装置)や,シミュレーションの計算条件を最低限の回数に抑える為に利用した例(文献[16],[17],及び[18]等のAlエッチング装置)があります.日本国内では,実験計画法はあまり浸透していないような気がしますが,米国の主要な半導体製造装置メーカーでは積極的に利用していると思われます.
☆
さて,反応メカニズムを検討する場合ですが,量産機を用いるよりも,非常に単純な実験装置を用いる方が効率的で,より多くの情報が得られます.代表的な例としては,以下のような論文があります.
Chemical reaction engineering in the design of CVD reactors
Chemical Engineering Science 54(1999) 1941-1957
H. Komiyama, Y. Shimogaki, Y. Egashira
"論文から学ぶ" で最初に取り上げている著者の方々が発表されている論文です.
必ずしも,全ての CVDプロセスが詳細に解析できるとまでは言えないと思いますが,多くの CVD プロセスに適用することが出来る上,気相と表面の反応のどちらが律速しているか,といった基本的な情報の他にも,見かけの活性化エネルギー・反応レートを算出することが可能です(「見かけ」とは,一般に素反応を指しているわけではなく,複数の反応ステップの中で律速している代表的なステップ,という趣旨で使っています).
反応炉には,二次元軸対称のモデルとして考えることが可能な円管を用います.また,円筒の直径を変えられるように,複数の円管を準備します.装置の概要は,以下のようになります.
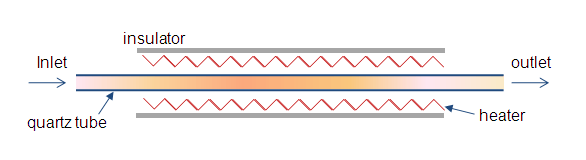
Fig. 1 二次元軸対称と見なせるシンプルな実験装置
小さなサンプル基板を予め円管内に配置し,その基板面上の成膜速度を調べることになります.温度が非常に高い場合は,heater の部分に誘導コイルを用いるなど,構成を変える必要もありますが,基本的なコンセプトは,軸対称と見なせることと,温度分布を均一に保てる構造を有すること,の2点でしょう.
なお,論文の後半では,micro/macrocavity と呼ばれる測定方法も紹介されており,上記の装置による解析と組み合わせることにより,より多くの情報を得ることが可能です.
☆
これらの装置とそのシミュレーションモデルを用いて実験する場合,温度・圧力・流量(及び,流量比),管径などが主なパラメータとなります.温度を変える場合は,可能な限り,アレニウスプロットを作成するのに十分なデータをとることが望ましいと言えます.また,管径を変えた際に,アレニウスプロットがどのように変化するかを知ることで,気相と表面のどちらの反応が律速しているか,という情報も得られます.
圧力や流量は,僅かな違いで大きく異なる結果が得られる場合もある一方で,オーダー(桁)で変えることで初めて見えてくる違いに気付く場合もあります.実際には,排気速度をどこまで調整できるかによって,調べられる圧力領域が限定されてしまう場合が多いと思いますが,これらの値は,大きく変えてみないと有意義な違いが得られない場合もあることを考慮すべきでしょう.
実際の装置で良好と考えられている条件を含めることも重要ですが,トレンドを掴む上では,あまり元の条件に捕われず,ある程度大きくパラメータを変更し,実験とシミュレーションの両方の立場から実験結果を解釈するのが一番望ましいと言えます.明らかに実用的ではないプロセス条件も,その原因を把握出来ていると,後々の詳細な検討に役立てられる場合も少なくないと思います.
☆
back to home > Door to Reactor Simulation(目次) > 1.5 or 1.3
© 2008 ATHENASYS Co., Ltd. All Rights Reserved.
