1.2 必要となる実験・計測データ
< Last Update : Nov. 11 2008 >
熱CVDに代表される反応炉のシミュレーションでは,計算グリッド( メッシュ )やソフトウェアの計算精度に影響するオプションの設定に注意を払う以前に,実験装置の温度分布を模擬・再現するための準備があります.妥当な温度分布を再現出来ない解析モデルですと,非常に細かな計算グリッドを用いたり,残差を小さくする努力をしても,本来望んでいるような計算結果を得ることは困難です.
気相や表面の反応速度のほとんどは温度に依存しますので,反応を考慮する以前に,妥当な熱解析モデルを作成することが必要になります.その為には,装置がどのような部材で構成され,どのように組まれているか(熱的な抵抗が大きいか小さいか,等)を把握しておくことが不可欠です.例えば,これから計算したいモデルが,従来の装置よりも大きいものだとしても,いきなりその大きなモデルを計算することは一般的に困難です.しかし,従来の装置から設計思想が違わない場合は,既存の装置を再現出来る解析モデルを準備しておくことで,新しい(仮想的な)装置の解析モデルのどの部分に注意を払うべきかを事前にチェックし,シミュレーションに本来望まれる結果を得ることも可能になります.
☆
既存の装置で知るべきデータは,CVD装置の場合,基板上の成膜速度分布も勿論必要となりますが,成膜する面だけでなく,基板周辺の成膜速度分布や温度分布も欲しいところです.一般に,装置内では,基板面以外にも成膜します.膜質は同じではないかも知れませんが,基板面以外の成膜量が無視出来ない量の場合,この影響を考慮しないモデルでは,実験結果を再現することがやはり難しくなってきます.プロセスによっては,基板面以外の成膜を考慮しないと,成膜速度が定性的に合わない可能性も出てきます.
実験装置であれば,熱電対や放射温度計で部分的に温度測定が可能な場合もあると思いますが,量産機の場合,色々な事情により,十分な温度測定は難しいと思います.いずれにしても,温度に依存して変化する特性を利用し,装置内の温度分布を把握したいものです.
装置内の温度測定は,成膜したい基板上だけでなく,その上流や下流,基板に対抗した面など,プロセスガスが接する面内の多くの点で測定しておくことが望まれます.その為の一つの方法として,成膜条件における温度測定とは別に,プロセスガスをキャリアガスや不活性ガスで置換した条件で温度測定を行うことをしばしばご提案しています.プロセスガスを導入する場合には難しい温度測定も,成膜が生じない条件下であれば温度の測定が可能,という場合もあると思います.
☆
温度の測定を行う際,装置の内壁だけではなく,装置の外側についても,同時に温度測定することをお薦めします.投入された電力は,その大半が熱となって逃げて行きますので,チャンバー部材の温度もかなり高温になる部分もあるはずです.また,ロードロック室のような熱容量の大きなチャンバーが成膜室に接続されている場合,熱解析のモデルに何処まで考慮するか,結構悩ましい場合もあります.必ず考慮しないと目的の解析モデルが出来ない,というわけではありませんが,何らかの形で考慮した方が良い場合も考えられます.
外側は,手で触れる部分もあるでしょうから,室温よりもかなり高い部分や,温度勾配がついていそうな部分について,複数点測定を行い,全体としてどのような温度分布になっているかを測定の段階でイメージ出来れば理想的です.なお,装置がかなり大きい場合は,装置の熱容量もそれだけ大きくなり,内部だけ暖まって外側の温度は飽和していないことも考えられます.シミュレーションでは,一般に定常解析(十分長い時間が経過した後の状態を解として得る解析)を行いますので,温度の測定結果は,低めに見積もる可能性があることも考慮しておくとよいでしょう(時間経過による変化を確認することで,どの程度の誤差が生じるか,予想出来る場合もあります).
成膜に限らず,基板の処理時間が短い場合,定常解析では不十分な場合もあります.特に,プラズマを用いる装置( PCVD や Dry Etching 等)の場合,処理する最初と処理した最後で,基板の温度がかなり異なる場合もあります.この場合は温度測定もより難しくなり,RF を印可する場合には,熱電対を装置内にいっさい配置出来ない場合も出てきます.Plasma が関与する場合は,サーモラベル等,別の手段も利用し,放電を立てた時と立てない時の最高温度を別々に測定する,といった方法も考える必要があるかもしれません.
更に,ヒートサイクルがシミュレーションの目的で,カセットの1枚目と25枚目の温度差を問題とするような場合は,その最初と最後(必要に応じてその途中)の基板の温度を個別に調べる,といったことが必要になるかも知れません.ヒートサイクルを問題にする場合は,定常計算ではなく非定常の計算が必要となり,この場合は,装置の外側よりも,装置内部の温度分布を知ることがより重要になってきます.
☆
その他にも注意しておきたい点として,ヒータ(及び,装置を加熱する装置)の電流と電圧を調べておくと,投入した電力が分かります.また,水冷等による冷却装置がある場合は,その流量やクーラントの比熱,in/out の温度差を測定しておくと,どれだけの熱を冷却装置が奪っているかを確認することも可能です.
Fig. 1 は,サセプターの内部にシースヒータが配置され,基板に対向してシャワーヘッドが置かれているような装置に関し,可能であれば温度測定してみたいポイントを,赤い丸印で示してみました.装置が非対称の場合は,図のような片側だけでなく,反対側の右半分,或は,周方向にも測定出来ると理想的です.
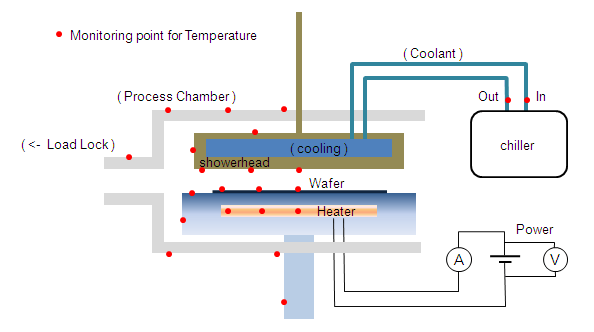
Fig. 1 温度の測定箇所(向って装置の左半分と,Chiller の In/Out の例)
ちなみに,冷却部の冷却効率を向上させる為に,流路を少し大きくし,その一方で,内部に数多くのフィンを配置して高電力に対応可能な冷却システムを,シミュレーションで検討したこともあります.気体と液体とでは,振る舞いが大きく異なるので,クーラントの流れをシミュレーションする場合は,別の注意も必要です(次節以降の説明では,冷却システムについてはひとまず割愛したいと思います).
装置やプロセスによって測定すべき項目は様々ですが,目的に応じて,解析するモデルと比較したい測定データを出来るだけ準備しておき,既存の装置の温度分布を精度良く再現することが出来れば,次のステップが期待できるでしょう.
☆
home > Door to Reactor Simulation(目次) > 1.3 or > 1.1
© 2008 ATHENASYS Co., Ltd. All Rights Reserved.
